上一期讲解预布局的时候,有朋友提到热设计的输入条件:各个器件的工作功耗,和温度无法评估。所以这期我们来谈谈热设计。
硬件工程师VS热设计工程师
硬件工程师:“我们新出了一个方案,帮忙再仿真一下吧?”
热设计工程师:“过不了!”
硬件工程师:“你仿过了?”
热设计工程师:“我用脑袋仿过了,你过不了,你要降规格!”
硬件工程师:“老子要用烙铁给你脑袋加热”
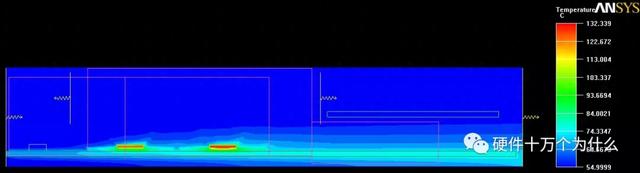
我写的这个笑话被很多和网站拷贝,这个笑话是我亲身经历的真实事件。
当时我刚到华为上班,意气奋发,结果就碰到这么一个不配合我们项目组工作的热设计工程师,还很不理解。
因为专门搞热仿真热设计的从业人口也比较少,特别是华为这个专门的工作,只有热设计工程师才可以使用仿真软件。所以当时热设计工程师是稀缺资源,硬件工程师也只能依赖热设计工程师进行仿真。
而很多公司热仿真的工作是结构工程师完成的。也有些能干的硬件工程师自己建模仿真。这个取决于个人的技术宽度、公司的分工要求、产品复杂度、必要性等。
不管是什么工程师来做这个工作,如果反复的仿真没有好的结论,都是资源浪费。自然就会有笑话中热设计工程师拒绝反复仿真各种情况的案例。
我们在硬件设计过程中,由于性能越来越高,速率越来越高,所以热设计的挑战也越来越大。特别是产品竞争进入白热化之后,在有限的机框里面达到散热极限边缘是很容易出现的。
热仿真效率低的原因有:
1、器件功耗大,散热风险大。
2、热设计仿真结果经常超过结温,或者不满足降额。
3、有些给出的器件功耗值缺乏理论依据,不准确,导致过设计或者导致散热风险。
4、热仿真的过程需要多次反复,一次仿真的周期大约3天,效率低下。
有时候硬件工程师按照项目经验经过多次调整,才能满足热设计的要求,而且不断地改热设计的输入条件,导致效率很低。

对于风险器件,我们需要做到两点:
1、准确的给出器件实际功耗。
2、最优化的散热布局,考虑走线的前提的下的最优布局。
关于器件功耗评估
对于没有散热风险的器件,我们评估功耗的时候,可以很粗暴地给一个标称最大值。但是当这样简单操作,给出一个最大值之后,不能通过热仿真的时候,需要我们去调整这个值,需要评估到最准确的值。
1、例如,DDR3控制器支持高刷新率,则其结温可达到95℃,如果不支持高刷新率,则最高结温定为85℃。必要时,硬件实现提高刷新频率功能,则DDR3温度规格放宽为95度。其他器件如果有硬件指标跟温度相关,一样要根据实际需求和实际场景去评估其温度上限要求。
2、对于散热风险较小的仿真模型,可以建立简单的电源模型,按照经验值输入。对于设计风险较大单板,需要建立电源详细模型,硬件人员需要提前评估功耗,提供给热设计人员。特别是MOSFET,有时候为了简化模型,直接布放一个热源,进行仿真。但是由于功耗大,所以我们要根据MOSFET的实际使用情况,利用功耗计算公式,计算出其实际的功耗,然后再确定其功耗参数。同时,需要考虑一些覆铜,亮铜改善其散热的情况。
而不是简单的降规格妥协,或者换更贵更好性能的器件,要么影响产品竞争力,要么提升了成本。
具体计算可以参考:开关电源 MOS管损耗
3、CPU的功耗要根据其是否降频工作,超频工作,实际工作负载情况进行评估。不能拿最大功耗一刀切。
X86处理如果支持Turbo Burst模式,需要考虑多种情况的散热分析
由于Nehalem架构处理支持Turbo Burst模式,所以虽然处理的总功耗一定,但是处理各个点的功耗会随着不同的Turbo模式,导致各个Core的最大功耗会超过其额定功耗。需要分别考虑各种情况的散热。不然超频的时候,单点功耗会比较高。
我们曾经有个案例,使用多核PowerPC,其功耗比较高,热仿真一直评估有风险,但是我们根据实际业务场景,重新评估了实际工作负载能力,合理的评估了其真实环境下的实际工作功耗,降低功耗之后仿真通过。后来实测,也不会出现过温的现象。
对于处理器这种,需要的时候,应该投入人力,用demo板对实际工作环境进行实测,提前做热测试,保障功耗评估准确。
同样的,DDR也需要根据其实际工作速率进行评估其功耗,特别是FPGA的外挂DDR,有时没有想象的那么大功耗。
4、FPGA 的功耗,一般厂家会提供评估工具。这时,一定要根据实际FPGA的资源占有情况进行评估,不要按照100%进行评估。实在评估值偏高,也可以用Demo板实测功耗。
关于热设计相关的PCB布局、结构设计、生产工艺的案例。
1、共用散热器,需要考虑器件公差及导热硅胶的厚度。
当时有个案例,我们有一个电路板上面,CPU和另外一个器件共用了散热器,自己公司的热设计工程师的仿真结论温度比较高,而使用相同的仿真模型,器件厂家散热仿真模型的温度比较低,经过器件厂家讨论,分析原因是器件厂家建立的仿真模型,CPU与散热器的导热胶厚度为0.13mm,而我们目前仿真模型中使用的仿真模型是0.3mm。导致:器件厂家仿真模型中CPU的温度是95摄氏度,而我们的仿真结果是:大于116摄氏度。自己公司的热设计工程师选择0.3mm是参考两个器件公差,得出的经验值,选取了概率比较高的一个参考值。
实际生产过程中,导热硅胶的厚度很难控制那么精准,需要制造特殊的涂胶工装来保证其厚度。不然确实会出现大功率器件温度过高,出现过热保护的情况。
建议:最好不要多个器件共用散热器。由于器件高度公差,导致导热硅胶厚度影响散热效果。
如果多个器件共用散热器,需要充分考虑器件高度公差带来的影响。
2、有些场景下,DDR在正反面,为了方便走线,有些工程师把TOP面和BOTTOM面的DDR在空间上位置完全重叠。但是这样重叠设计,DDR的热量也会通过PCB板相互传递,不利于散热,可以考虑错开一点进行设计。有时在指标就差一点点的时候,有效的优化。
3、如果散热器件后方如果有扣板等平板型物体,不一定会阻碍器件散热,有可能形成风道,加大局部风速。有时风道会改善散热,所以不要拿脑袋仿真。
4、散热有叠加效应。如果存在很大散热风险,我们优先考虑结温要求最苛刻,功耗大的器件放在进风口。例如DDR。
5、过孔、亮铜会改善散热
PCB 过孔对散热的影响
6、加散热铜箔和采用大面积电源地铜箔。

根据上图可以看到:连接铜皮的面积越大,结温越低

根据上图,可以看出,覆铜面积越大,结温越低。
转载请注明来自海坡下载,本文标题:《网站建设硬件(硬件详细设计)》

 京公网安备11000000000001号
京公网安备11000000000001号 京ICP备11000001号
京ICP备11000001号
还没有评论,来说两句吧...